Pretražni elektronski mikroskop
Način rada
Pretražni elektronski mikroskop omogućuje promatranje i karakterizaciju heterogenih organskih i anorganskih materijala na nanometarskoj (nm) i mikrometarskoj (μm) razini. Površina koju želimo ispitati ili mikro-obujam kojega želimo analizirati ozračen je dobro fokusiranim elektronskim snopom u svrhu stvaranja slike ili za elementnu analizu uzorka. Rezultati međudjelovanja elektronskog snopa s uzorkom mogu biti: sekundarni elektroni (emitirani iz uzorka), povratno raspršeni elektroni (iz elektronskog snopa) i karakteristično rendgenskog zračenje emitirano s uzorka. Signali se mogu koristiti za ispitivanje različitih karakteristika uzoraka, kao što su topografija površine, kristalografija, kemijski sastav, itd.
Teme istraživanja uključuju istraživanje morfologije i debljine različitih poluvodičkih ili izolatorskih filmova dobivenih tehnikom depozicijom atomskih slojeva, dijatomeje ili alge kremenjašice (slatkovodne i morske), pustinjsku prašinu, mikroplastik, bakterije, ortodontske uzorke, aerosol i mnoge druge materijale.
Naš uređaj

JEOL pretražni elektronski mikroskop s emisijom polja (JSM-7800F) s maksimalnom rezolucijom od 0.8 nm, naponom ubrzanja između 0.01 – 30 kV i rasponom povećanja: x25 – 1.000.000, opremljen sa sljedećim detektorima:
- Donji detektor za sekundarne elektrone (LED)
- Gornji detektor za sekundarne elektrone (UED)
- Detektor za povratno raspršene elektrone (BED)
- Detektor za transmitirane elektrone (STED)
- Energo-disperzivni detektor rendgenskih zraka X-MaxN 80, Oxford Instruments (EDS) – korišten za analizu elementnog sastava uzorka
Naša oprema za pripremu uzoraka

Različiti precizni uređaji za pripremu uzoraka:
- Uređaj za precizno jetkanje i naprašivanje (Gatan PECS II Model 685) – s dva ionska topa za jetkanje čvrstih uzoraka s nisko-energetskim Ar+ ionima (raspon energija 0.1 – 8 keV). Također se može koristiti za naprašivanje uzoraka s C, Au, Pt/Pd, Cr i Pt.
- Uređaj za precizno ionsko poliranje (Gatan PIPS II Model 695) – s dva ionska topa za poliranje čvrstih uzoraka s nisko-energetskim Ar+ ionima (raspon energija 0.1 – 8 keV). Primarno se koristi za pripremu uzoraka za pretražnu transmisijsku elektronsku mikroskopiju (STEM).
- Uređaj za sušenje koji radi na principu kritične točke (Quorum K 850) – korišten za dehidrataciju bioloških uzoraka (zamijenjuje vodu s tekućim CO2).
- Precizna pila s dijamantnom žicom (Well 3242) – žica iz nehrđajučeg čelika s dijamantnim česticama koristi se za rezanje različitiv vrsta uzoraka. Omogućuje dobivanje glatkih i oštrih rubova.
- Disc Grinder – koristi se za stanjivanje uzorka.
- Dimple Grinder - koristi se za stanjivanje uzorka do elektronske transparentnosti pogodnu za STEM/TEM analizu uzoraka.
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618
Spektroskopija fotoelektrona
rendgenskim zrakama
Način rada
Spektroskopija fotoelektrona rendgenskim zrakama (X-ray Photoelectron Spectroscopy, XPS) ili elektronska spektroskopija za kemijsku analizu (Electron Spectroscopy for Chemical Analysis, ESCA) je analitička tehnika za proučavanje elementalne strukture i kemijskih stanja na površinskim slojevima uzoraka. Primjenjuje se na širokom spektru materijala, od metala i poluvodiča do organskih ili bioloških uzoraka i polimera. XPS se temelji na međudjelovanju rendgenskih zraka s atomima na površini uzoraka, koje uzrokuje emisiju fotoelektrona s površine. Energije fotoelektrona, koje se analiziraju u elektronskom analizatoru, karakteristične su za pojedine elemente prisutne unutar volumena pobuđenja. XPS je izrazito površinska tehnika s dubinom uzimanja signala do približno 70 Å. Uz dodatak izvora ionskih snopova koji na kontrolirani način mogu uklanjati slojeve površine, XPS nalazi široku primjenu u dubinskom elementnom profiliranju uzoraka i mjerenju debljine i uniformnosti tankih filmova. Posebnost XPS tehnike leži u mogućnosti određivanja kemijskog stanja detektiranih elemenata na površinama, poput razlikovanja oksidacijskih stanja različitih elemenata.
Naš uređaj

Uređaj za spektroskopiju fotoelektrona rendgenskim zrakama (XPS) njemačkog proizvođača SPECS, opremljen sljedećim uređajima:
- FOCUS 500 – monokromatizirani izvor rendgenskih zraka (Al Kα i Ag Lα)
- PHOIBOS 100 MCD-5 – hemisferični analizator energije elektrona (promjera 100 mm) s detektorom od 5 kanala
- IQE 11/35 – ionski top za niskoenergetske ione inertnih i reaktivnih plinova (0.3-5 keV)
- IQE 12/38 – ionski top s fokusiranom ionskom zrakom i diferencijalnim pumpanjem
- precizan XYZ manipulator nosača uzoraka s kontroliranim grijanjem i hlađenjem (LN2-800 °C)
- FG500 – elektronski top za neutralizaciju površine
- Residual Gas Analyser (Prisma Plus QMG 220)
- Kontakt:
- izv. prof. dr. sc. Robert Peter
- rpeter@phy.uniri.hr
- +385 51 584 621
- Kontakt:
- izv. prof. dr. sc. Robert Peter
- rpeter@phy.uniri.hr
- +385 51 584 621
Masena spektrometrija sekundarnih iona
Način rada
Masena spektrometrija sekundarnih iona (Secondary Ion Mass Spectrometry, SIMS) je analitička tehnika za elementnu analizu i mjerenje ultraniskih koncentracija primjesa i nečistoća u različitim materijalima i tankim filmovima s posebno značajnom primjenom u fizici poluvodiča i poluvodičkoj tehnologiji. Detekcijske granice su za većinu elemenata u ppm ili čak u ppb području, pa je po tome SIMS jedna od najosjetljivijih tehnika za elementnu analizu. SIMS se temelji na detekciji iona (sekundarnih iona) izbijenih s površine uzorka za vrijeme bombardiranja površine energetskim ionima (primarnim ionima). Primarni ioni erodiraju površinu (eng. sputtering), a mali postotak izbačenih atoma ili molekula je ioniziran (sekundarni ioni). Kao izvor primarnih iona naš uređaj koristi ione Cs+, O2+ ili Ar+, a može detektirati pozitivne ili negativne sekundarne ione (atomske i molekularne) u rasponu od 1 amu do 500 amu, koristeći kvadrupolni maseni analizator.
SIMS mjerenja mogu se izvoditi u tri načina rada: statički, dinamički i SNMS način rada. U statičkom modu, SIMS se koristi za analizu elemenata na samoj površini uzoraka, a u dinamičkom modu, kroz eroziju površine (stvaranje kratera na površini), za dubinsko profiliranje elemenata. SNMS način rada (Masena spektroskopija sekundarnih netralnih čestica, Sputtered Neutral Mass Spectroscopy) omogućuje detekcije neutralnih atoma i molekula. Neutralni atomi izbačeni s površine uzoraka za vrijeme ionskog bombardiranja prije ulaska u kvadrupol se ioniziraju pomoću elektronskog izvora.
Naš uređaj
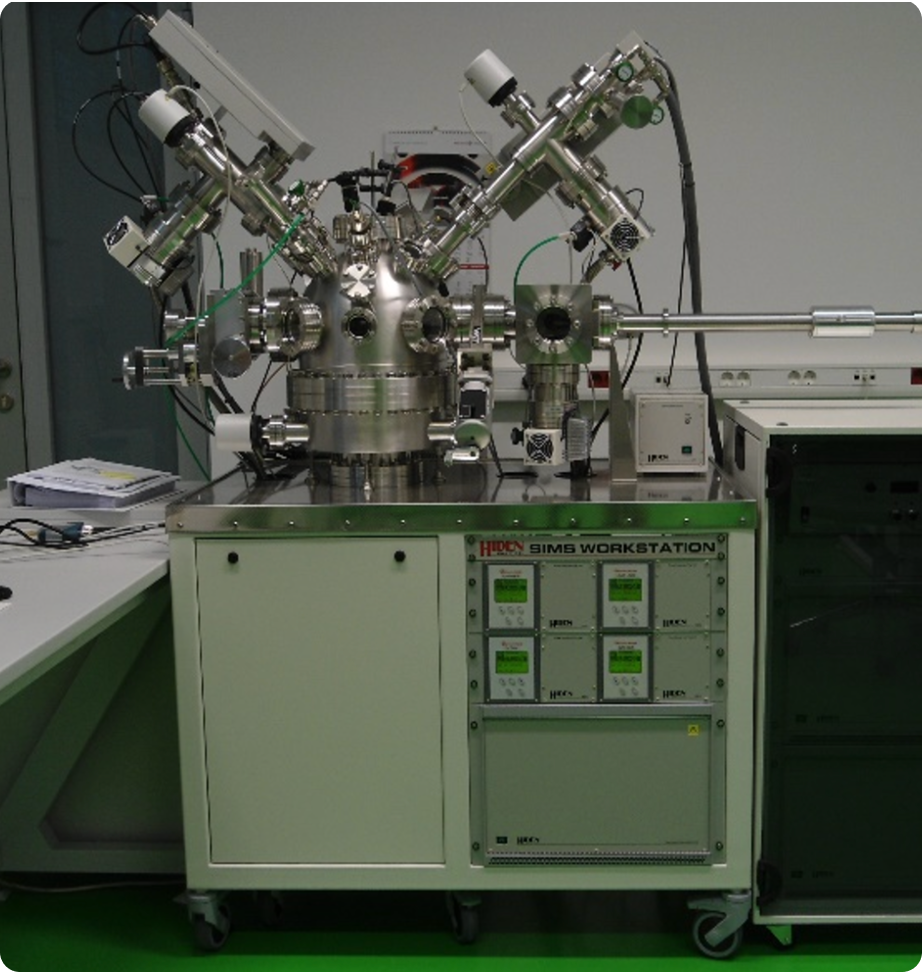
SIMS instrument je Hidden system sa sljedećom opremom:
- Ionski pištolj za niskoenergetske ione inertnih i reaktivnih plinova (IG20) s energetskim rasponom od 0,5 – 5 keV (O2+ ili Ar+ ioni) i promjerom ionske zrake od 100 μm
- Cezijev ionski top (IG5C) s energetskim rasponom od 0,5 – 5 keV i promjerom ionske zrake od 100 μm
- kvadrupolni analizator mase (MAXIM HAL7) s rasponom mase: 1 – 500 amu i Puls Ion Counting Electron Multiplier detektorom
- Izvor ionizacije analizatora zaostalog plina (Residual Gas Analyser, RGA)/raspršene neutralne masene spektrometrije (Sputtered Neutral Mass Spectrometry, SNMS)
- Elektronski top (FG 500 – SPECS sustav) – za neutralizaciju učinaka površinskog naboja
Naša oprema za obradu uzoraka
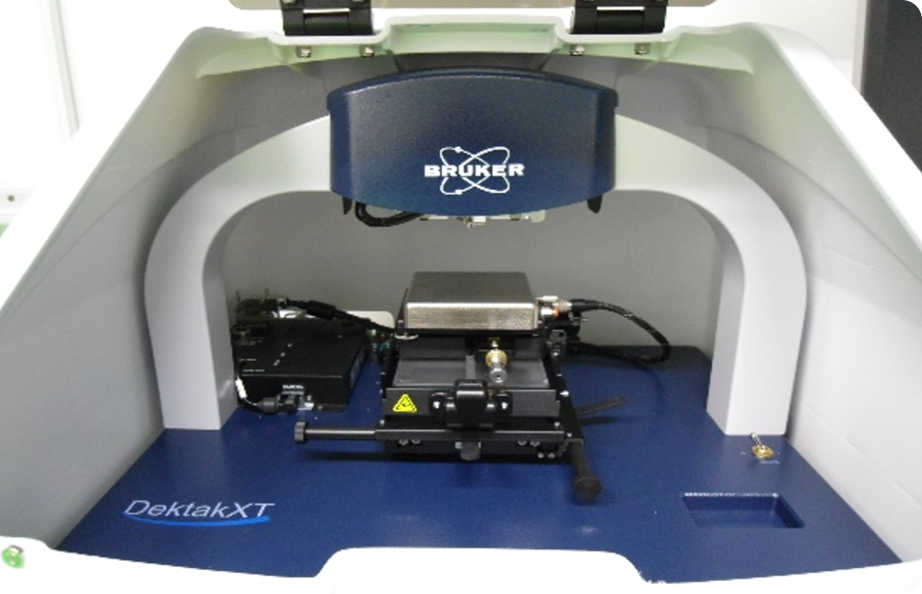
Bruker DektakXTTM stylus profiler – služi za mjerenje različitih fizičkih svojstava površine materijala. U našem laboratoriju prvenstveno se koristi za mjerenje dubine kratera nakon SIMS dubinskog profiliranja i hrapavosti površine.
- Kontakt:
- izv. prof. dr. sc. Robert Peter
- rpeter@phy.uniri.hr
- +385 51 584 621
- Kontakt:
- izv. prof. dr. sc. Robert Peter
- rpeter@phy.uniri.hr
- +385 51 584 621
Uređaj za depoziciju atomskih slojeva
Način rada
Uređaj za depoziciju atomskih slojeva (ALD) je tehnika koja se koristi za depoziciju tankih anorganskih filmova s velikom preciznošću kontrole debljine. ALD je tehnika depozicije iz pare kojom se mogu narastati tanki filmovi na površinama različitih podloga: planarnim objektima, poroznim materijalima i kompleksnim 3D objektima. Karakterističan ALD proces se sastoji od pulsiranja najčešće dva prekursora u plinovitoj fazi koji reagiraju s površinom podloge. Ovaj proces se ponavlja sve dok se ne postigne željena debljina filma. Zbog samoograničavajuće prirode ALD kemijskih procesa moguće je narastanje uniformnih slojeva jednake debljine bez obzira na geometriju supstrata, precizno kontroliranje sastava i debljine filma. U našem ALD sistemu najčešće se sintetiziraju oksidni tanki filmovi kao što su: ZnO, Al2O3, TiO2, SiO2 i nitridi: AlN, TiN, Si3N4.
Naš uređaj

Uređaj za depoziciju tankih filmova (ALD) – sistem Beneq TFS 200
- Raspon temperatura sinteze: 25 – 500 °C
- Maksimalne dimenzije uzorka (obična komora): promjer 200 mm, visina 3 mm
- Maksimalne dimenzije uzorka (3D komora): promjer 200 mm, visina 95 mm
- Sistem kapacitivne plazme (RF od 13,6 MHz, snaga plazme do 300 W)
- Generator ozona (ozon se može koristiti kao izvor za ALD sintezu)
- 4 tekuća spremnika prekursora spojena na sistem
- Kontakt:
- izv. prof. dr. sc. Iva Šarić Janković
- iva.saric@uniri.hr
- +385 51 584638
- Kontakt:
- izv. prof. dr. sc. Iva Šarić Janković
- iva.saric@uniri.hr
- +385 51 584638
Spektrofotometar
Način rada
UV-Vis spektrofotometar omogućuje spektrofotometrijska mjerenja u ultraljubičastom i vidljivom djelu elektromagnetskog zračenja s materijom.
U našem laboratoriju pomoću uređaja UV-Vis spektrofotometar EVOLUTION 201 najčešće proučavamo dekolorizaciju bojila tijekom fotokatalitičkoga procesa.
Naš uređaj

Uređaj UV-Vis spektrofotometar EVOLUTION 201 posjeduje sljedeće specifikacije:
- Spektrofotometar EVOLUTION 201 - jednozračni spektrofotometar s Czerny-Turne monokromatorom
- Izvor zračenja: halogena i deuterijska lampa, detektor: silicijske fotodiode
- Raspon mjerenja: 200 - 1100 nm
- Način skeniranja: apsorpcija, % transmitancija, % refleksija, Kubelka-Munk, log (1/R), log (Abs), Abs*faktor, intenzitet
- Širina pukotine: 1 nm
- Raspon brzina skeniranja: <1 to 6000 nm/min
- Kontakt:
- izv. prof. dr. sc. Aleš Omerzu
- aomerzu@phy.uniri.hr
- +385 51 584 634
- Kontakt:
- izv. prof. dr. sc. Aleš Omerzu
- aomerzu@phy.uniri.hr
- +385 51 584 634
Fotoluminiscencijski spektrometar
Način rada
Naš uređaj

- detektor za brojanje jednog fotona i pripadna elektronika
- osjetljivost uređaja: Odnos signal – šum >35 000:1 (mjereno na Ramanskom signalu vode)
- kontinuirano podesivi bandpass upravljan računalom
- računalno kontrolirani filtarski kotačići za ekscitaciju i emisiju za automatizirano uklanjanje višeg reda sa 6 položaja
- Monokromatori: Dvostruki ekscitacijski monokromator, prigušenje rasipne svjetlosti: > 1:1010 Jednostruki emisijski monokromator, prigušenje raspine svjetlosti: > 1:105
- Izvori svjetlosti: CW Xe2 lampa, 450W, s integriranim napajanjem i Pulsna μF2 - 60 W
- Spektralni raspon od 200 nm do 870 nm, s frekvencijom tamnih impulsa <50 cps, te širinom odziva 600 ps
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618
Uređaj za pripremu uzoraka u presjeku
Način rada
Naš uređaj

Uređaj za pripremu uzoraka u presjeku IB-19530CP:
- Instrument za pripremu uzorka u presjeku koji ne stvara neravnine, stepenaste nepravilnosti ili kontaminaciju
- Potpuno automatski rad, od vakuuma, ionskog brušenja, finog brušenja do završne obrade
- Brzina glodanja max do 700 µm/h na siliciju (pri akceleracijskom naponu od 8 kV)
- Promjer ionskog snopa od 500 µm
- Rotacijski nosač koji omogućuje uklanjanje slojeva naprezanja nastalih mehaničkim poliranjem, veličine 40 mm (promjer) x 15 mm (V) ili više, s mogućnošću nagiba od 0° do 90°
- Jedna fiksna argonska ionska puška (kako bi se izbjeglo povećanje temperature na površini uzorka i neželjeno diferencijalno jetkanje uzrokovano prisutnošću više pušaka)
- Kut zakretanja postolja za uzorak od ±30° ili više kako bi se izbjegao učinak zavjesa i ponovno taloženje
- Izmijenjujuće (intermitentno) glodanje s podesivim tajmerom ON/OFF od 1 do 999 sekundi ili više, kako bi se omogućilo održavanje temperature na površini uzorka ispod 40°C bez potrebe za kriogenim hlađenjem
- Mogućnost naprašivanja ugljikom koristeći argonsku ionsku pušku unutar instrumenta za pripremu uzorka u presjeku
- CP uređaj je sposoban za: Rezanje presjeka Brušenje ravne površine Diferencijalno jetkanje Naprašivanje ugljikom svježe rezanog uzorka unutar polirača
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618
- Kontakt:
- izv. prof. dr. sc. Ivna Kavre Piltaver
- ivna.kavre@uniri.hr
- +385 51 584 618